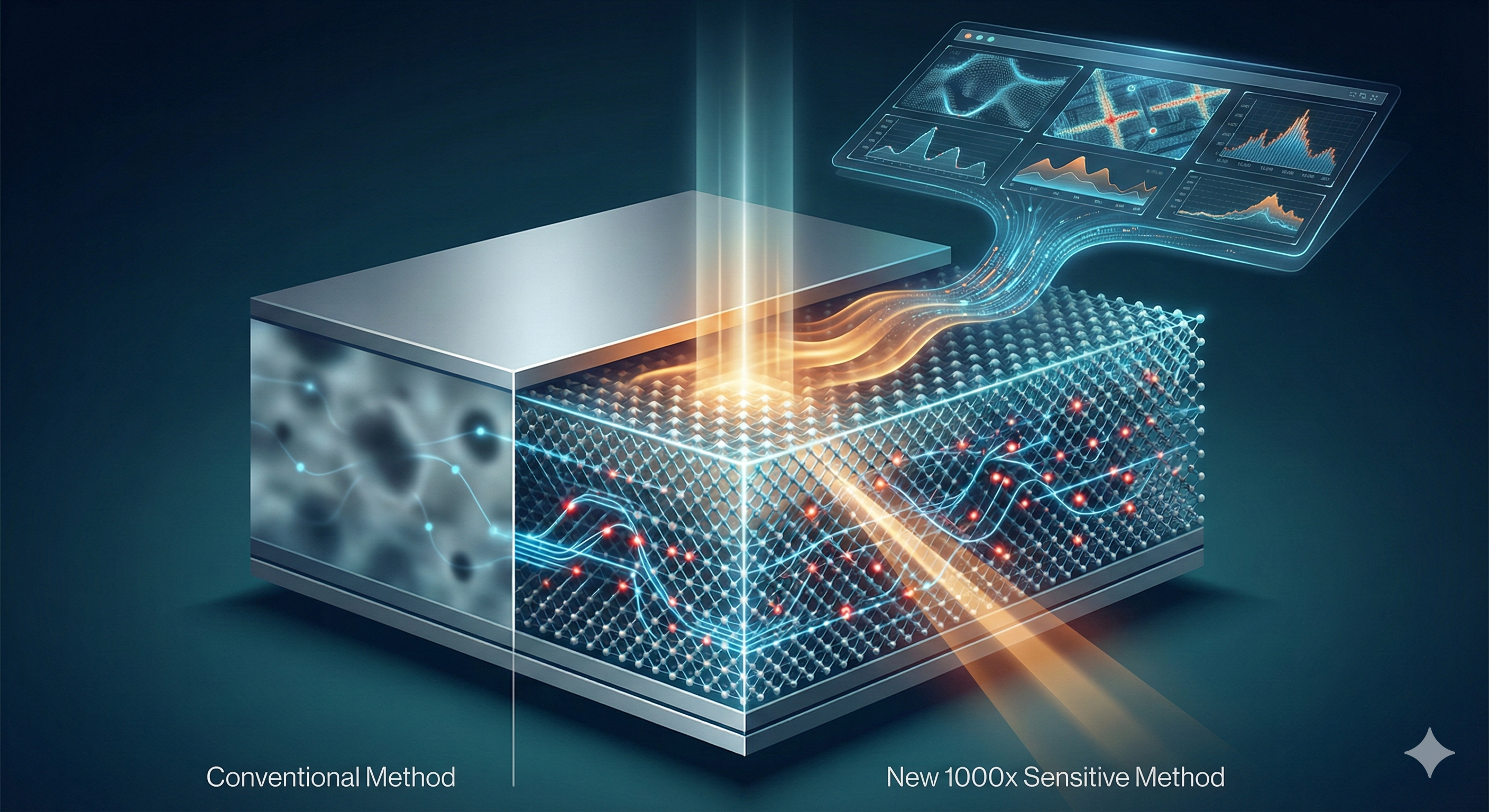
KAIST, 반도체 숨은 결함 1,000배 더 민감하게 찾아낸다
반도체 내부에 숨어 있는 미세한 결함을 기존보다 약 1,000배 더 민감하게 찾아낼 수 있는 분석 기술이 개발됐다. KAIST(총장 이광형) 신소재공학과 신병하 교수와 IBM T.J. Watson 연구소의 오키 구나완(Oki Gunawan) 박사 공동 연구팀은 8일, 반도체 내부에서 전기 흐름을 방해하는 결함(전자 트랩, 전자를 먼저 붙잡아 이동을 막는 반도체 내부 결함)과 전자의 이동 특성을 동시에 분석할 수 있는 새로운 측정 기법을 개발했다고 밝혔다. 연구팀은 오래전부터 사용된 Hall 측정(전기와 자기장을 이용해 전자의 움직임을 분석하는 방법)에 빛을 비추고 온도를 바꿔가며 측정하는 방식을 더해, 기존 방법으로는 확인하기 어려웠던 미세한 전자 트랩까지 찾아냈다. 이 기법을 실리콘 반도체와 차세대 태양전지 소재인 할라이드 페로브스카이트 박막에 적용한 결과, 기존 정전용량 기반 분석법으로는 검출하기 어려웠던 낮은 결함 밀도까지도 분석이 가능함을 확인했다. 연구 결과는 국제 학술지 ‘Science Advances’ 1월 1일자에 게재됐다.

보이지 않는 결함이 반도체를 망친다
메모리 반도체와 태양전지는 모두 반도체로 만들어진다. 반도체가 제대로 작동하려면 전자가 내부를 자유롭게 이동할 수 있어야 한다. 하지만 반도체 안에는 보이지 않는 결함, 즉 전자 트랩(trap)이 숨어 있을 수 있다.
전자 트랩은 반도체 내부에서 전자를 먼저 붙잡아 이동을 막는 결함이다. 마치 도로 위의 함정처럼, 전자가 여기에 걸리면 전기가 원활히 흐르지 못한다. 그 결과 누설 전류(의도하지 않게 새어나가는 전류)가 생기거나 성능이 떨어진다. 특히 메모리 반도체와 태양전지처럼 전자의 생성·이동·재결합(전자와 양전하가 다시 만나 소멸하는 현상) 과정이 중요한 소자에서는 전자 트랩이 성능과 수명에 직접적인 영향을 미친다.
따라서 반도체 성능을 정확히 평가하려면 전자 트랩이 얼마나 많고(트랩 밀도), 전자를 얼마나 강하게 붙잡는지(트랩 에너지 준위, 밴드 가장자리로부터의 거리)를 알아내는 것이 중요하다. 하지만 기존 분석 기법들은 한계가 있었다. p-n 접합이나 쇼트키 접합 같은 특정 구조를 만들어야 하거나, 결함 특성과 전하 수송 특성(전자가 얼마나 빠르게 움직이는지 등)을 서로 다른 측정 방법으로 분리해 분석해야 했다.
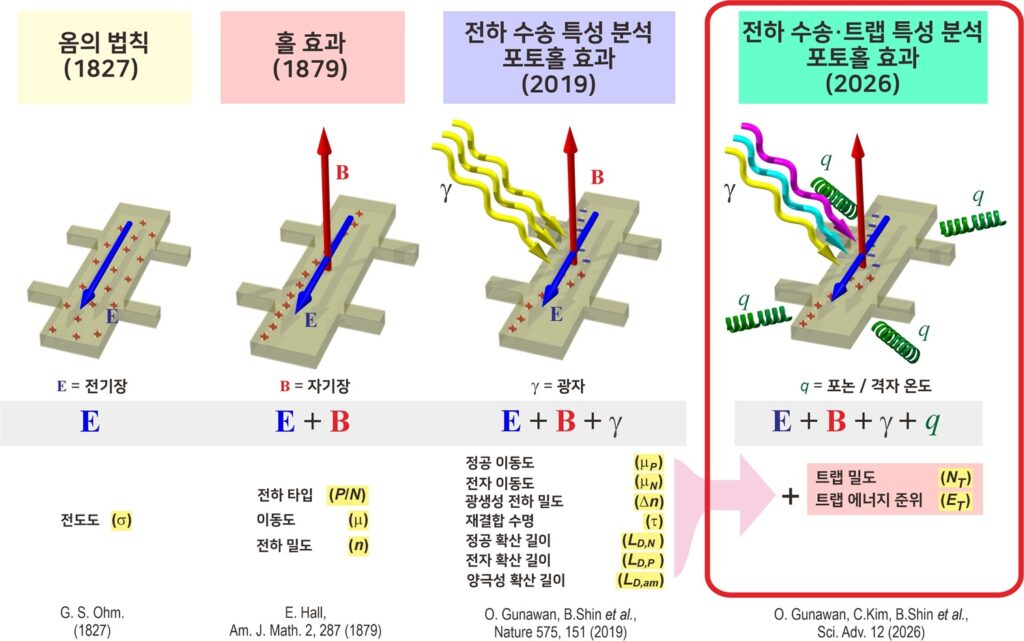
빛과 온도로 숨은 결함 찾아낸다
연구팀은 오래전부터 반도체 분석에 사용돼 온 Hall 측정에 주목했다. Hall 측정은 전류가 흐르는 반도체에 수직 방향의 자기장을 가하면 전하가 로렌츠 힘(자기장 속에서 움직이는 전하가 받는 힘)에 의해 횡방향 전압이 발생하는 Hall 효과를 이용한다. 이를 통해 전하 운반자의 종류, 밀도, 이동도(전자가 얼마나 빠르게 움직이는지)를 분석할 수 있다.
연구팀은 여기에 빛을 비추고 온도를 바꿔가며 측정하는 방식을 더했다. 핵심 아이디어는 빛의 세기를 조절하는 것이다. 빛을 약하게 비추면 새로 생긴 전자들이 먼저 전자 트랩에 붙잡힌다. 반대로 빛의 세기를 점점 높이면 트랩이 채워지고, 이후 생성된 전자들은 자유롭게 이동하기 시작한다. 연구팀은 이 변화 과정을 분석해 전자 트랩의 양과 특성을 정밀하게 계산할 수 있었다.
구체적으로, 연구팀은 빛 세기에 따라 변화하는 전도도(전류가 얼마나 잘 흐르는지)와 포토홀 전도도(전기 전도도, Hall 계수, 이동도를 결합한 분석 변수)의 관계를 그래프로 그렸을 때 나타나는 특징적인 휘어짐(bending)에 주목했다. 결함이 존재하면 이 그래프가 쌍곡선(hyperbola) 형태로 휘어진다. 연구팀은 이 수학적 모델을 분석해 결함 밀도와 에너지 준위를 정량적으로 추출할 수 있음을 밝혔다.
이 방법의 가장 큰 장점은 한 번의 측정으로 여러 정보를 동시에 얻을 수 있다는 점이다. 전자가 얼마나 빠르게 움직이는지(이동도), 얼마나 오래 살아남는지(재결합 수명), 얼마나 멀리 이동하는지뿐 아니라, 전자의 이동을 방해하는 트랩의 특성까지 함께 파악할 수 있다.
연구팀은 이 기법을 먼저 실리콘 반도체에 적용해 정확성을 검증한 뒤, 차세대 태양전지 소재로 주목받는 할라이드 페로브스카이트 박막에 적용했다. 그 결과 기존 정전용량 기반 분석법으로는 검출하기 어려웠던 낮은 결함 밀도까지도 분석이 가능함을 확인했다. 이는 기존 기술보다 약 1,000배 더 민감한 측정 능력을 확보했다는 의미다.
신병하 교수는 “이번 연구는 반도체 안에서 전기의 흐름과 이를 방해하는 요인을 하나의 측정으로 동시에 분석할 수 있는 새로운 방법을 제시했다”며, “메모리 반도체와 태양전지 등 다양한 반도체 소자의 성능과 신뢰성을 높이는 데 중요한 도구가 될 것”이라고 말했다.
이 기술의 실용적 가치는 크다. 반도체 개발 과정에서 불량 원인을 정확히 찾아내면 개발 비용과 시간을 크게 줄일 수 있다. 특히 차세대 반도체, 태양전지, 메모리 및 전자소자 연구에서 소재 품질 평가와 공정 최적화를 위한 핵심 분석 도구로 활용될 것으로 기대된다.
또한 이 기법은 접합 구조가 필요 없는 Hall 기반 분석법이라는 점에서 장점이 있다. p-n 접합이나 쇼트키 접합 같은 특정 구조를 만들 필요 없이 반도체 소재 자체의 본질적인 결함과 전하 수송 특성을 평가할 수 있다.